富士通的创新PCB技术F-ALCS及下一代玻璃基板技术G-ALCS
搬运FICT在油管上的两个视频,介绍了他们当前的创新PCB技术F-ALCS和下一代玻璃基板G-ALCS技术。
一、 F-ALCS

信息技术的急剧发展给用于先进数据处理设备的印制电路板(PCB)制造带来了极大的复杂性。行业内正在采取各种策略来应对这些挑战。FICT的做法是开发F全层Z连接结构技术,即F-ALCS技术。
◆什么是F-ALCS?
F-ALCS是一种结构技术,它能够通过使用独特的导电铜合金膏,在单次压合过程中连接所有层,从而形成超过70层的内埋通孔(IVH)结构。

选择F-ALCS技术主要有以下三个原因:
◆
优势1:提高安装和布线密度
这里有一个对比,左边是常规的内埋通孔(IVH)印制电路板结构,右边是F-ALCS印制电路板结构。常规的内埋通孔(IVH)印制电路板必须要有镀通孔(PTH),而这会限制安装空间。相比之下,F-ALCS技术通过仅在必要的层上设置过孔,解除了安装空间的限制。在常规的内埋通孔(IVH)结构中,要创建过孔就不可避免地会产生布线限制的问题,因为需要钻孔。而通过应用F-ALCS技术,可以在将所有层粘贴在一起之前就在每层上设置过孔。这种方法有助于避免内部结构中不必要的过孔,从而提高布线密度。F-ALCS技术能使电路板尺寸缩小10%到30%,并减少25%到50%的信号短截线。
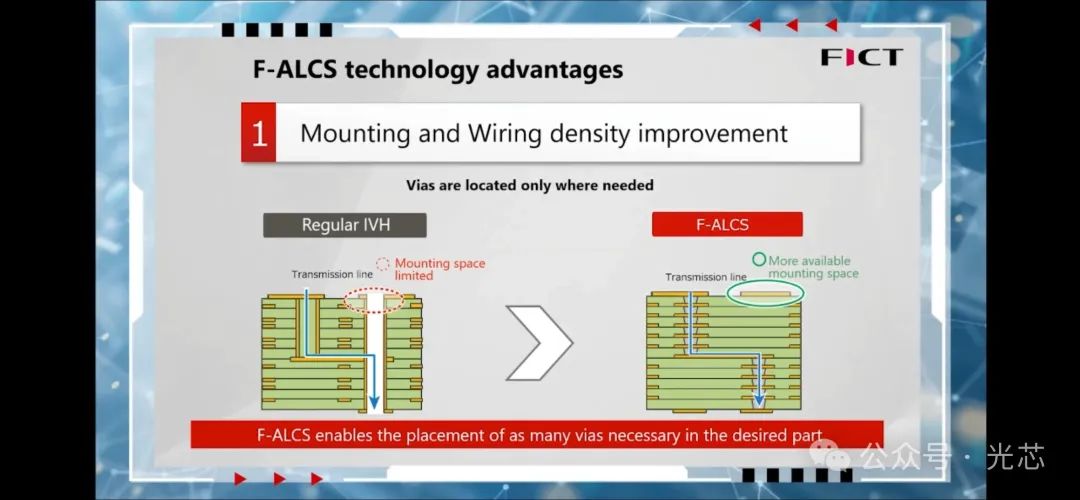

◆ 优势2:提升高速信号传输性能
这里有一个对比,一种情况是信号通过典型的通孔传输,另一种是F-ALCS结构中无开放式短截线的信号传输情况。通过消除开放式短截线,蓝色显示的F-ALCS技术在所有频率范围内展现出了改善的回波损耗和插入损耗特性。


优势3:交付时间快且环保
传统常规内埋通孔(IVH)印制电路板的生产涉及10个制造工艺步骤。而采用F-ALCS技术时,工艺流程是先利用导电膏并行连接内层,在形成激光通孔之后,通过一次性压合来完成所有的通孔连接。这一新工艺将制造步骤削减至5个,从而缩短了交付时间。
F-ALCS在生态友好性方面独具特色,因为它使我们能够省去电镀步骤。通过选择导电膏印刷工艺来进行通孔连接,就消除了对电镀液等废液处理的必要。选择这项技术使得制造过程中的运营成本和二氧化碳排放量降低了约40%。



◆ F-ALCS技术应用

该技术已被应用于提升印制电路板(PCB)在众多应用场景中的性能。该技术应用于高端服务器、5G基础设施以及高性能计算基板的高密度印制电路板,增强了布线能力并缩短了交付时间。随着对更大电路板尺寸的需求不断增长,需要大量布线以及高速数据传输,这一进步显得尤为重要。

探针卡中引脚数量的不断增加以及向更精细间距的转变,导致对更多布线以及超过16个单面增层的需求不断提高。通过采用F-ALCS技术来构建印制电路板的核心部分,能够显著增强布线能力并减少总层数。

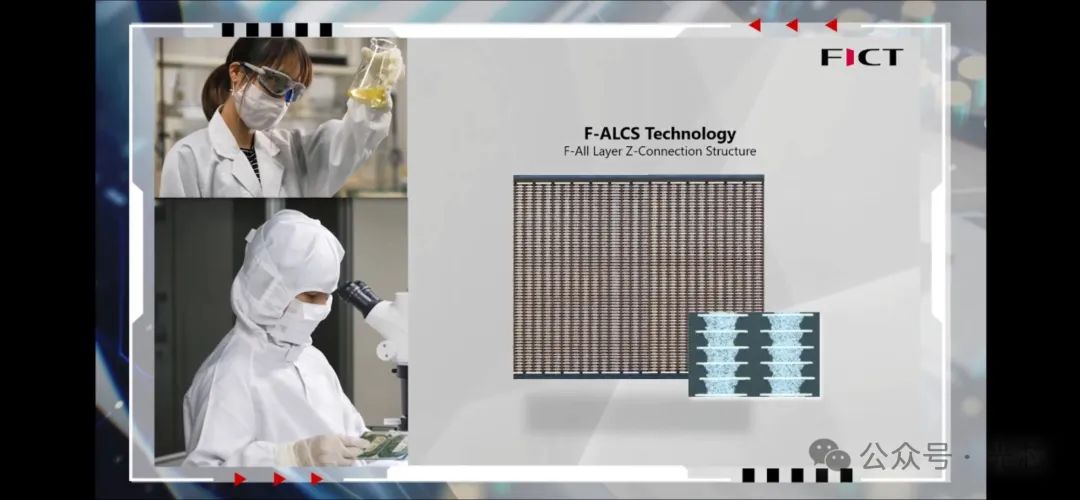
二、 G-ALCS

近年来,由于认识到有机材料存在的局限性,玻璃凭借其优越性能在全球范围内受到了极大关注。
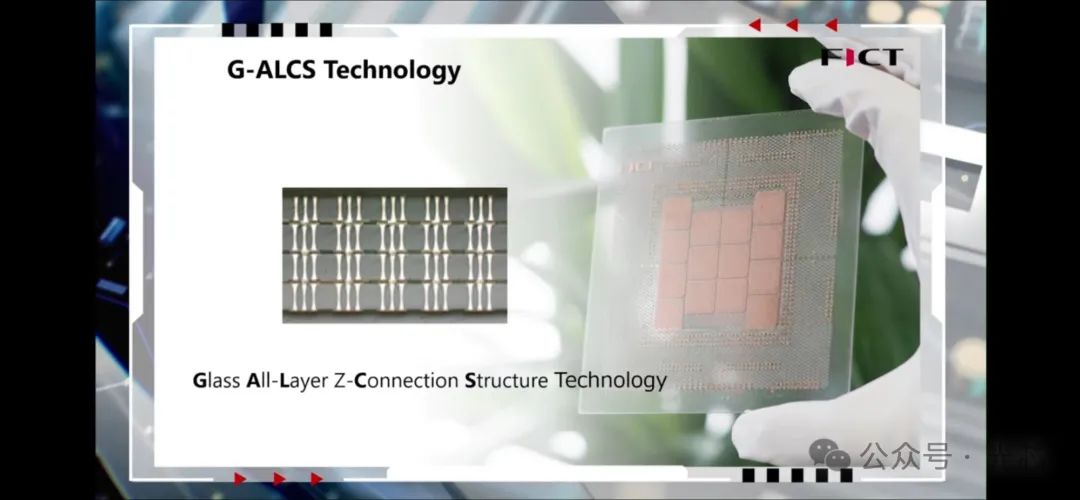
富士通开发了用于下一代半导体封装基板和探针卡基板的G-ALCS(玻璃全层Z连接结构)技术。G-ALCS代表玻璃全层Z连接结构。这种结构技术的基本理念目前仍处于开发阶段,它涉及将现有的F-ALCS技术应用于玻璃,利用独特的导电膏来连接多层玻璃。鉴于该材料具有出色的电气和机械性能,持续围绕它开展研发工作。
正如表中所示,玻璃的介电损耗角正切明显低于其他材料,这在高速传输方面是一项显著优势。此外,玻璃材料的热膨胀系数处于百万分之3至8.5的范围,这使其在可安装性方面极具优势。


随着步入人工智能(AI)、绿色转型(GX)以及6G技术领域,我们旨在利用G-ALCS技术开发下一代半导体封装基板和探针卡基板。这一举措旨在适应半导体不断演进的小芯片结构以及先进的芯片检测设备。富士通是先进印制电路板(PCB)开发领域的自豪先驱,珍视深植于我们基因之中的创新与技术演进精神。
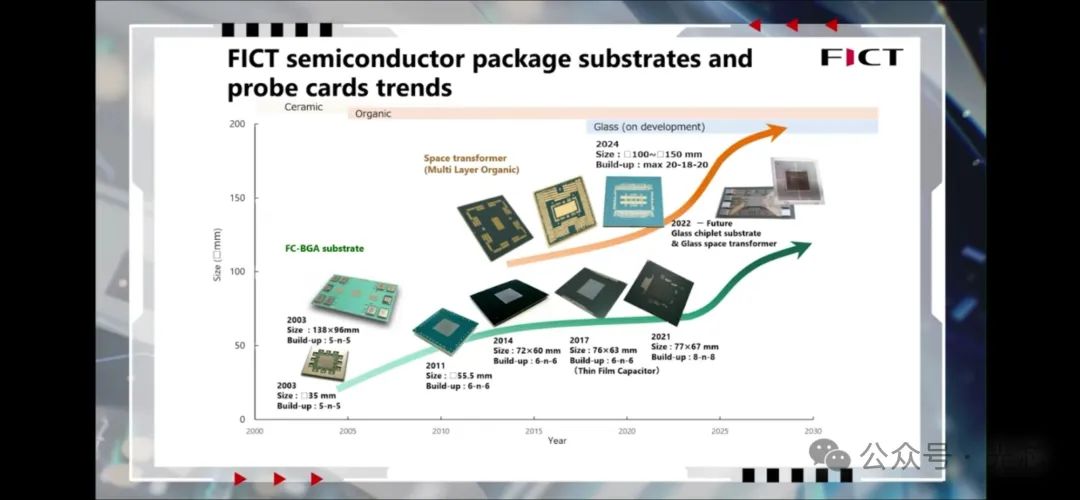
利用玻璃的卓越性能,富士通致力于开发与不断演进的小芯片架构相适配的下一代探针卡印制电路板以及半导体封装基板。
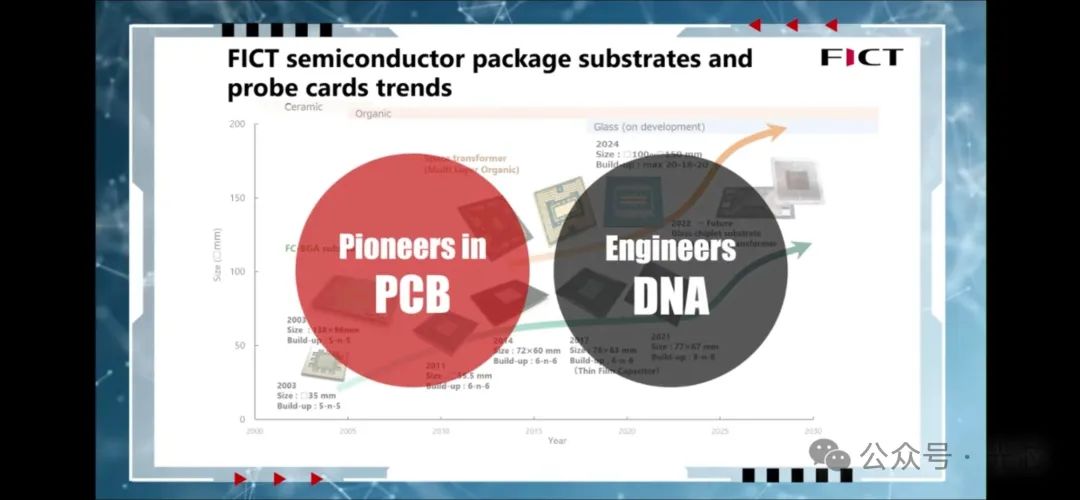
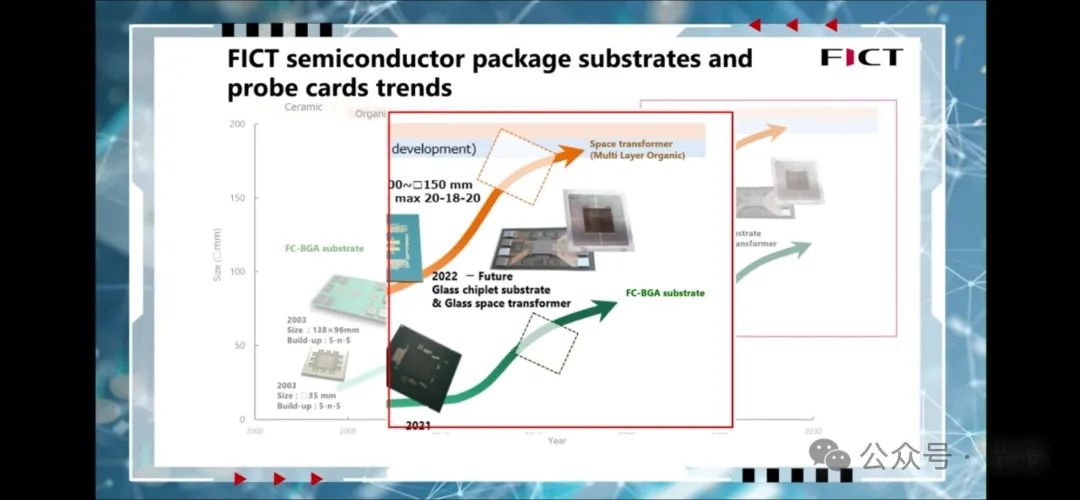

该结构的第一个优势在于形成玻璃多层结构。这里有一幅玻璃多层板结构的图片。要形成玻璃多层板,首先要在每层玻璃上构建玻璃通孔(TGV),然后使用独特的导电铜合金膏和树脂层将所有层压合在一起。这项技术能够制造出利用玻璃优越性能的多层布线板。


这项技术的第二个优势是多层结构的抗裂性能。将典型的带有双面增层的单玻璃芯模拟结果与采用G-ALCS技术制成的五层玻璃多层样品的模拟结果进行了对比。在进行内部应力模拟后,可以观察到单玻璃芯内部呈现出最高等级的应力(以红色显示)。通过将玻璃层压合在一起,成功地把应力水平降低到了较低范围。
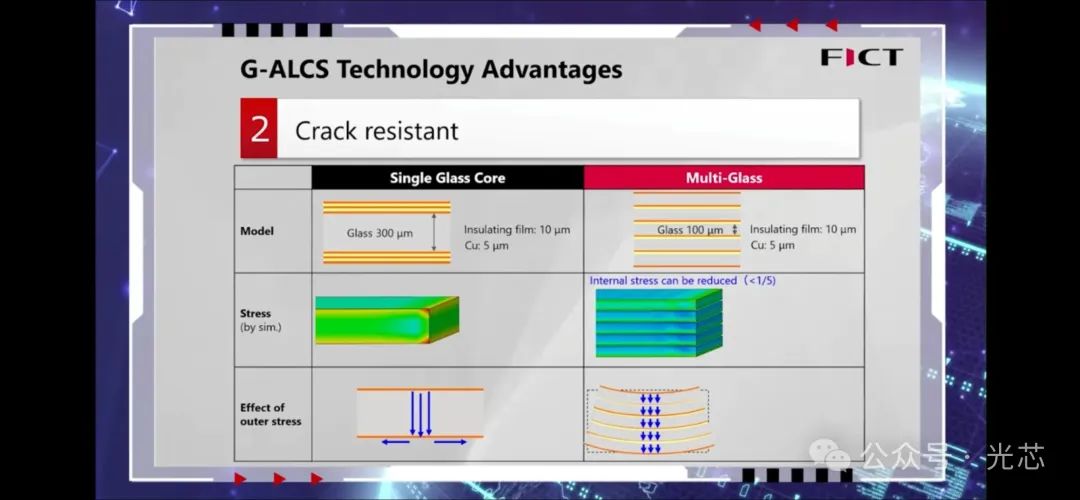
在外部应力模拟方面,可以发现单玻璃芯在受到应力作用时容易开裂。而另一方面,玻璃层之间以及多玻璃结构中的树脂层能够分散外部应力,使其更不容易开裂或破裂。目前,开裂和断裂是玻璃基板面临的一个大问题,富士通的多层玻璃结构则提供了一种解决这一问题的有效方案。
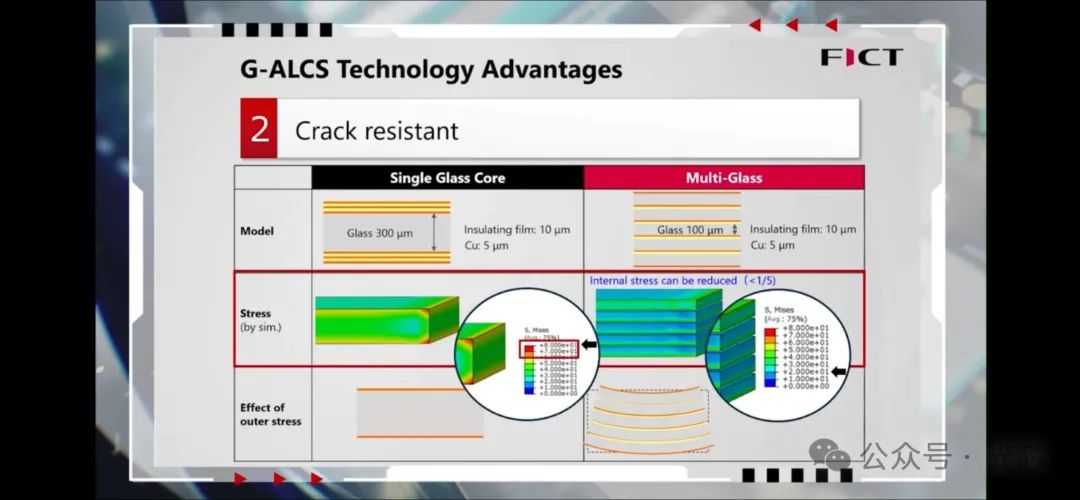
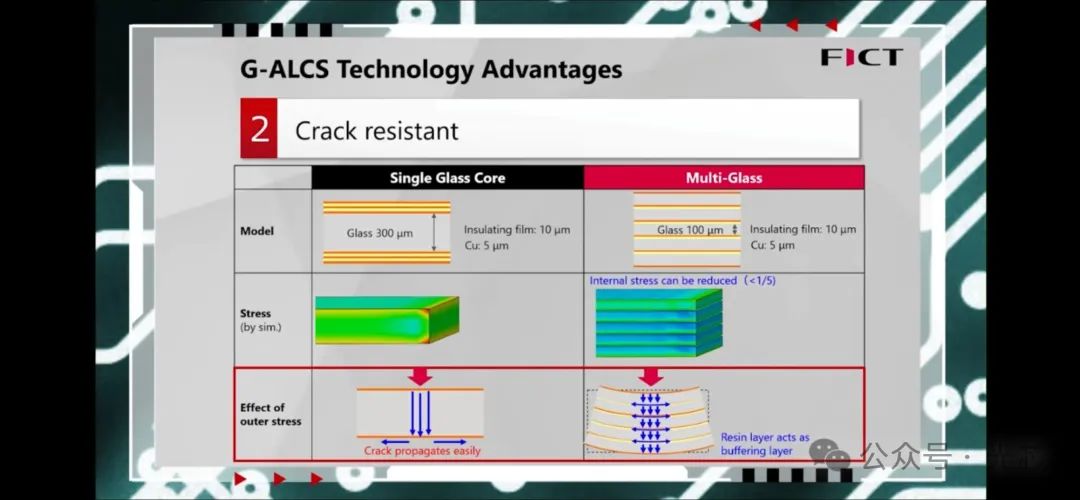

G-ALCS的第三个优势是即便在高温环境下也能够抑制基板翘曲。通过对采用G-ALCS技术的有机基板和玻璃基板之间的翘曲测量结果进行了对比,在整个温度变化过程中,G-ALCS几乎能保持与初始状态一致,这在提高可安装性方面是一项显著优势。
底下的横截面图展示了一个实际的基板,它是利用G-ALCS技术通过将四层玻璃层压形成一个八层多层玻璃结构而制成的。首先在每层玻璃上形成玻璃通孔(TGV),然后将所有层堆叠起来,利用导电膏和树脂层打造出了一个多层玻璃芯。
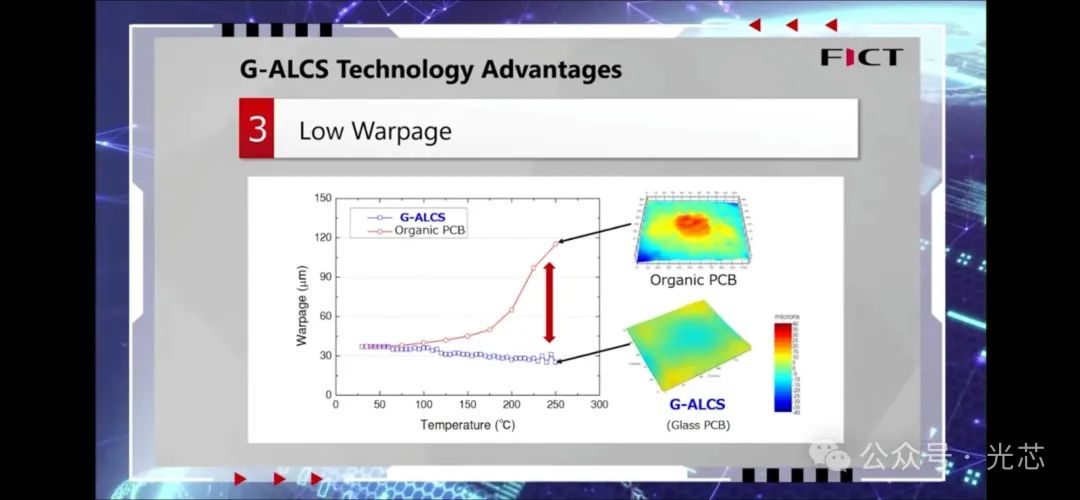

应用G-ALCS技术的一个主要关注点在于半导体封装基板。由于小芯片结构不断演进,目前高带宽内存(HBM)已与硅中介层相集成,而且富士通正在朝着2.XD集成迈进。
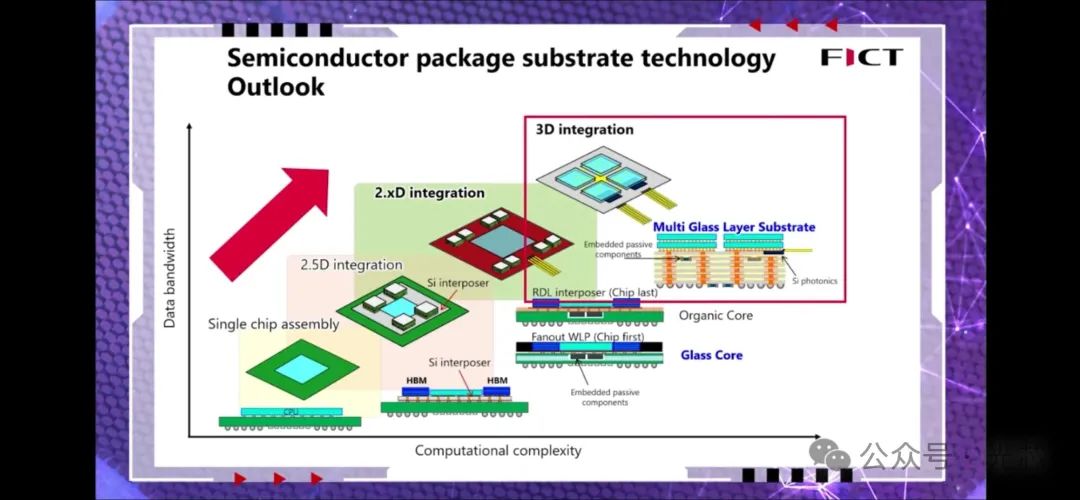
未来,小芯片结构的复杂程度和尺寸预计将会增加,随着向3D集成进一步发展,特别是为了通过绿色转型来降低功耗,只有将硅光子(SI)器件放置在芯片旁边,光电转换才能得以实现。
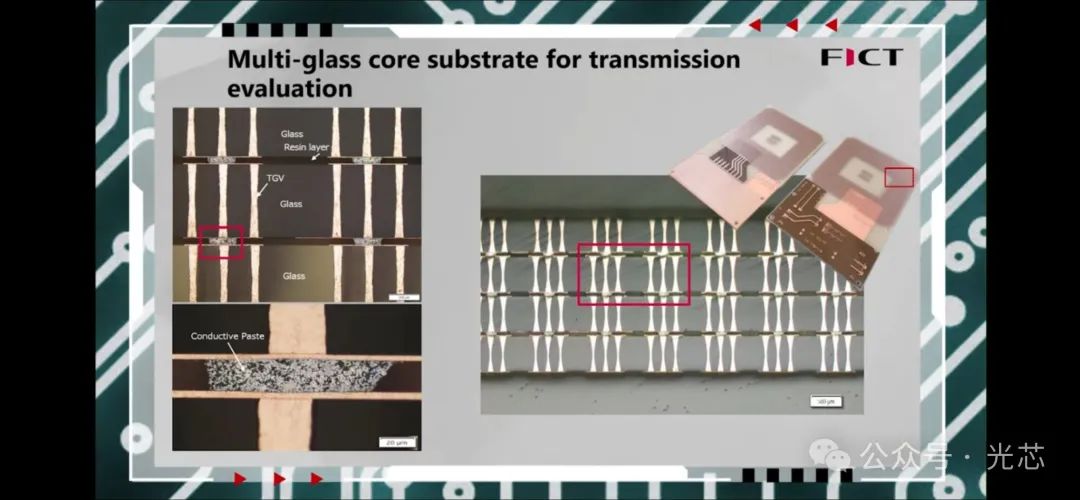
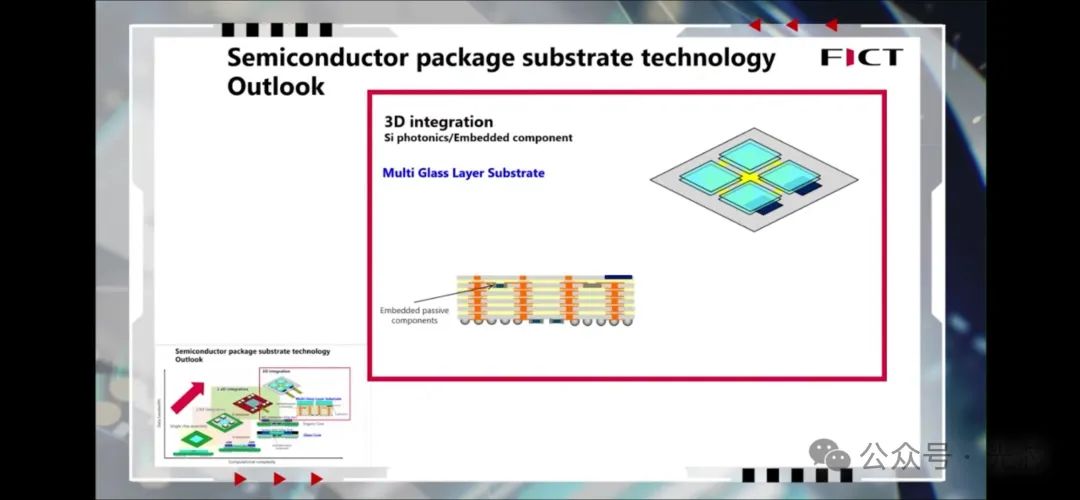
此外,对于高精度波导和光学安装的需求将促使人们转向使用玻璃,因为就目前而言,由于有机材料的热膨胀特性,它们已不再是可行的选择。
玻璃因其相较于有机材料所具备的优越性能而备受关注。最大限度地发挥玻璃的潜力将为半导体相关产品的新发展铺平道路,并使其成为一项具有变革性的技术。


本文参与 腾讯云自媒体同步曝光计划,分享自微信公众号。
原始发表:2024-12-09,如有侵权请联系 cloudcommunity@tencent.com 删除
评论
登录后参与评论
推荐阅读


